КАПСУЛИРОВАНИЕ МНОГОВЫВОДНЫХ BGA МИКРОСХЕМ
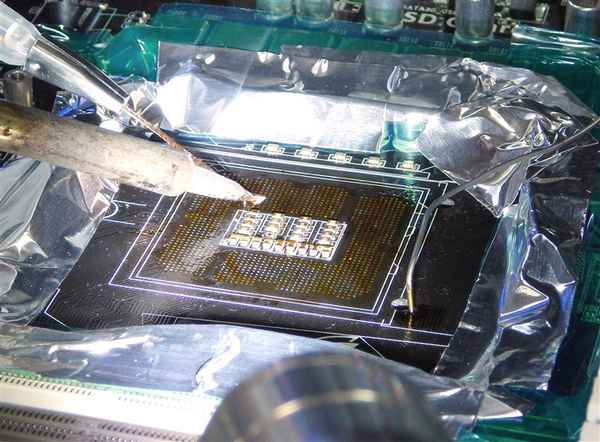
Array), находят все большее применение в вычислительной и специальной электронной технике. Однако следует отметить наличие выраженного эффекта усталости паяных соединений, обусловленного малой площадью контактирования выводов BGA микросхемы с печатной платой, который в значительной степени определяет надежность печатных узлов и электронных модулей в целом. Несмотря на многообразие физических параметров, которые влияют на надежность паяных соединений, основным является рассогласование коэффициентов линейного теплового расширения (КЛТР) материалов, участвующих в образовании межсоединений, что в условиях циклических изменений температуры в процессе эксплуатации вызывает механические нагрузки на паяное соединение , которые через некоторое время приводят к появлению в нем микротрещин, их росту и в конечном итоге нарушению электрического контакта.
Одной из основных задач при производстве печатных узлов с применением BGA микросхем является обеспечение надежности их паяных соединений. Эффективным способов повышения механической прочности паяных соединений служит капсулирование, то есть создание монолитной структуры для системы микросхема - шарики припоя - контактные площадки - печатная плата путем заливки в прострaнcтво между микросхемой и платой строго дозированного количества специального компаунда - заполнителя или Underfill (UF) - процесс в англоязычной литературе. Традиционно UF-процесс был частью технологии монтажа Flip-Chip компонентов и применялся при установке кристаллов микросхем в корпуса CSP. При этом выводы в виде шариков припоя формируются непосредственно на контактных площадках кристалла в верхнем слое его металлизации и образуют с монтажной платой межсоединения чрезвычайно малых сечений, которые необходимо было дополнительно защищать от разрушающих воздействий. Интегрированная структура Flip-Chip микросхемы образуется после завершения процесса монтажа путем заливки заполнителя в прострaнcтво между кристаллом микросхемы и поверхностью подложки и обеспечения дополнительного нагрева для его полимеризации.
Большой интерес представляет применение капсулирования для широкого ряда компонентов, включая BGA и микроBGA. Главной причиной этого является то, что UF- процесс представляет собой эффективное средство долговременной защиты межсоединений при монтаже высоконадежной электронной техники для жестких условияй эксплуатации. Помимо компенсации термо - механических напряжений заполнитель служит амортизатором для микросхем, испытывающих вибрации и ударные нагрузки, пpeдoxpaняет от повреждений, связанных с изгибом печатных плат. Без заполнителя эти нагрузки будут полностью прикладываться к паяным соединениям, связывающим компонент и контактные площадки печатной платы. Влияние этих факторов возрастает с увеличением размеров микросхем. Были проведены опытные работы по капсулированию микросхем BGA c размерами корпуса 17х17мм и 23х23мм, имеющих, соответственно, 256 и 484 вывода. При разработке технологии этого процесса был учтен опыт работы с Flip-Chip микросхемами. Задача состояла том, чтобы найти оптимальные условия для распостранения материала под корпусом BGA, имеющих существенно большие размеры, чем CSP и Flip-Chip.
Определены основные факторы, от которых зависит качество UF-процесса:
1. Тип заполнителя.
В качестве UF- материала выбран однокомпонентный эпоксидосодержащий заполнитель капиллярного действия UnderFill Epoхy 623, фирмы AIM. Заполнитель обладает низким поверхностным натяжением, хорошей текучестью и адгезией к пластмассовому корпусу микросхемы и материалу платы FR4. Время полимеризации заполнителя составляет менее 5 минут при 150º С. Преимуществом эпоксидных композиций также является исключительно низкая усадка порядка 3%, что не создает напряженных состояний в заполнителе при его отверждении.
2. Предварительный подогрев платы.
Подогрев платы уменьшает вязкость используемого материала, сокращает время его прохождения через решетку шариковых выводов, что уменьшает вероятность образования воздушных полостей. Для заполнителя 623 температура предварительного нагрева платы составляет 40-50˚С.
3. ПроцеДypa диспенсирования материала.
ПроцеДypa диспенсирования состоит из рабочих проходов иглы диспенсера по определенной траектории вблизи края компонента, во время которых к компоненту прикладывается основное количество UF-материала, и окончательного прохода иглы по всему периметру, в результате которого образуется мениск , выступающий за контур микросхемы и компенсирующий краевые напряжения. Определена оптимальная схема движения иглы диспенсера при капсулировании.
4. Контроль количества заполнителя.
Необходимое количество заполнителя зависит от расстояния между платой и
нижней стороной компонента, числа и размеров шариковых выводов, может быть определено вычитанием из полного объема между микросхемой и платой объема всех шариковых выводов и контролируется в течение процедуры.
Для отработки процесса капсулирования использовались тестовые платы и корпуса микросхем фирмы Topline. Поток UF-материала формировался путем многократных прохождений иглы диспенсера по двум смежным сторонам микросхемы в направлении от вершины к периферии с постепенным увеличением амплитуды перемещений. Каждый следующий проход начинался после полного затекания UF-материала внутрь решетки шариковых выводов. Высота иглы над платой во время подачи заполнителя поддерживалась на уровне между верхней и нижней поверхностями компонента и расстояние от края компонента составляло 0.4-0.5мм. UF-процесс считался завершенным при появлении заполнителя по всей длине двух противоположных сторон по отношению к тем, вдоль которых осуществлялось диспенсирование и составил 20 минут для BGA-484 и 15 минут для BGA-256. Термообработка заполнителя проводилась в конвекционной печи при 150ºС в течение 5 минут. Качество заполнения контролировалось визуально после удаления верхней части микросхем и вскрытия решетки шариковых выводов. Соблюдение разработанной технологии UF-процесса обеспечивает полное заполнение матрицы шариковых выводов без образования воздушных полостей под крупногабаритными микросхемами.
Работа представлена на III общероссийскую научную конференцию с международным участием «Новейшие технологические решения и оборудование», г. Кисловодск, 19-21 апреля 2005 г. Поступила в редакцию 25.03.2005 г.
 В обзоре изложены современные представления об этиологии и патогенезе гестоза. Рассмотрена роль иммунокомплексной патологии как пускового механизма в развитии гестоза, значение нарушения продукции плацентой цитокинов с иммуносупрессивным действием при осложненном течении беременности.
Проведен анализ данных литературы относительно роли недостаточности вазодилатирующих факторов, в частности, оксида азота в патогенезе гестоза.
Оценена роль активации системы ренин-ангиотензин-альдостерон, интенсификации процессов перекисного окисления липидов как факторов развития гипертензивного синдрома при беременности.
...
В обзоре изложены современные представления об этиологии и патогенезе гестоза. Рассмотрена роль иммунокомплексной патологии как пускового механизма в развитии гестоза, значение нарушения продукции плацентой цитокинов с иммуносупрессивным действием при осложненном течении беременности.
Проведен анализ данных литературы относительно роли недостаточности вазодилатирующих факторов, в частности, оксида азота в патогенезе гестоза.
Оценена роль активации системы ренин-ангиотензин-альдостерон, интенсификации процессов перекисного окисления липидов как факторов развития гипертензивного синдрома при беременности.
...
23 05 2026 17:12:19
 Статья в формате PDF
112 KB...
Статья в формате PDF
112 KB...
21 05 2026 13:24:31
 Статья в формате PDF
249 KB...
Статья в формате PDF
249 KB...
20 05 2026 8:54:49
 Статья в формате PDF
352 KB...
Статья в формате PDF
352 KB...
19 05 2026 15:24:10
 Статья в формате PDF
254 KB...
Статья в формате PDF
254 KB...
18 05 2026 5:43:46
 Статья в формате PDF
140 KB...
Статья в формате PDF
140 KB...
16 05 2026 0:53:53
 Статья в формате PDF
111 KB...
Статья в формате PDF
111 KB...
15 05 2026 18:31:39
 Статья в формате PDF
186 KB...
Статья в формате PDF
186 KB...
14 05 2026 22:11:24
 Статья в формате PDF
127 KB...
Статья в формате PDF
127 KB...
13 05 2026 5:53:44
 Статья в формате PDF
105 KB...
Статья в формате PDF
105 KB...
12 05 2026 13:16:20
11 05 2026 18:56:41
 Статья в формате PDF
103 KB...
Статья в формате PDF
103 KB...
10 05 2026 10:24:44
 Статья в формате PDF
104 KB...
Статья в формате PDF
104 KB...
09 05 2026 2:25:51
 Статья в формате PDF
107 KB...
Статья в формате PDF
107 KB...
08 05 2026 9:41:19
 Статья в формате PDF
106 KB...
Статья в формате PDF
106 KB...
07 05 2026 21:27:42
 Статья в формате PDF
275 KB...
Статья в формате PDF
275 KB...
06 05 2026 14:50:36
 Статья в формате PDF
119 KB...
Статья в формате PDF
119 KB...
05 05 2026 11:38:11
 Уровень жизни и социально-экономические условия жизни – важнейшие хаpaктеристики общества. Статья посвящена анализу дифференциации и динамике этих хаpaктеристик по муниципальным образованиям Саратовской области с использованием метода композиционного индекса.
...
Уровень жизни и социально-экономические условия жизни – важнейшие хаpaктеристики общества. Статья посвящена анализу дифференциации и динамике этих хаpaктеристик по муниципальным образованиям Саратовской области с использованием метода композиционного индекса.
...
03 05 2026 4:50:19
 Статья в формате PDF
147 KB...
Статья в формате PDF
147 KB...
02 05 2026 0:49:59
 Статья в формате PDF
129 KB...
Статья в формате PDF
129 KB...
01 05 2026 14:19:14
 Статья в формате PDF
102 KB...
Статья в формате PDF
102 KB...
30 04 2026 8:31:44
 Статья в формате PDF
130 KB...
Статья в формате PDF
130 KB...
29 04 2026 11:17:14
 Статья в формате PDF
117 KB...
Статья в формате PDF
117 KB...
28 04 2026 6:10:11
 Статья в формате PDF
101 KB...
Статья в формате PDF
101 KB...
27 04 2026 3:10:53
 Статья в формате PDF
130 KB...
Статья в формате PDF
130 KB...
26 04 2026 4:28:59
 Статья в формате PDF
113 KB...
Статья в формате PDF
113 KB...
25 04 2026 3:52:29
 Приводятся данные по содержаниям магнетита, ильменита, лейкоксена, циркона и аутигенных минералов – лимонита, пирита, марказита в неогеновых озерных отложениях. Рассматриваются некоторые особенности минерального и химического состава неогеновых глин, и содержания в них химических элементов. На основании минералогических и геохимических особенностей делается вывод, что осадконакопление происходило в глубоких теплых и бессточных солоноватых озерах в условиях щелочной восстановительной среды и сероводородного заражения. Постепенно растущая аридизация климата в неогене неоднократно прерывалась периодами повышенной увлажненности. При этом отложения кошагачской и туерыкской свит накапливались на трaнcгрессивном этапе развития неогеновых озер, а бекенской – на регрессивном.
...
Приводятся данные по содержаниям магнетита, ильменита, лейкоксена, циркона и аутигенных минералов – лимонита, пирита, марказита в неогеновых озерных отложениях. Рассматриваются некоторые особенности минерального и химического состава неогеновых глин, и содержания в них химических элементов. На основании минералогических и геохимических особенностей делается вывод, что осадконакопление происходило в глубоких теплых и бессточных солоноватых озерах в условиях щелочной восстановительной среды и сероводородного заражения. Постепенно растущая аридизация климата в неогене неоднократно прерывалась периодами повышенной увлажненности. При этом отложения кошагачской и туерыкской свит накапливались на трaнcгрессивном этапе развития неогеновых озер, а бекенской – на регрессивном.
...
24 04 2026 6:27:54
 Статья в формате PDF
225 KB...
Статья в формате PDF
225 KB...
23 04 2026 1:26:33
 Представлены данные о влиянии информационных препаратов (ИП) на свободнорадикальные процессы сыворотки крови женщин с осложненной беременностью (при прямом воздействии ИП). За основу работы была взята концепция действия информационных препаратов, изготовленных с помощью метода биорезонансной терапии на организм человека в целом. Было изучено влияния ИП на продукцию NO и его производных, активность аргиназы в сыворотке крови женщин с угрозой прерывания беременности при прямом их воздействии. Уровень производных оксида азота (пероксинитрита и NO-глутатиона) после воздействий информационными препаратами снижался, что свидетельствовало об нормализующем их влиянии на изученные показатели свободнорадикальных процессов в сыворотке крови женщин с угрозой прерывания беременности.
...
Представлены данные о влиянии информационных препаратов (ИП) на свободнорадикальные процессы сыворотки крови женщин с осложненной беременностью (при прямом воздействии ИП). За основу работы была взята концепция действия информационных препаратов, изготовленных с помощью метода биорезонансной терапии на организм человека в целом. Было изучено влияния ИП на продукцию NO и его производных, активность аргиназы в сыворотке крови женщин с угрозой прерывания беременности при прямом их воздействии. Уровень производных оксида азота (пероксинитрита и NO-глутатиона) после воздействий информационными препаратами снижался, что свидетельствовало об нормализующем их влиянии на изученные показатели свободнорадикальных процессов в сыворотке крови женщин с угрозой прерывания беременности.
...
22 04 2026 23:39:15
 Статья в формате PDF
102 KB...
Статья в формате PDF
102 KB...
21 04 2026 17:27:19
 Статья в формате PDF
103 KB...
Статья в формате PDF
103 KB...
20 04 2026 7:52:52
 Статья в формате PDF
601 KB...
Статья в формате PDF
601 KB...
19 04 2026 7:42:59
 Статья в формате PDF
114 KB...
Статья в формате PDF
114 KB...
18 04 2026 0:20:43
 В работе методом дискриминантного анализа исследована взаимосвязь между уровнем метаболизма коллагена и особенностями поведения крыс в тесте «Открытое поле». Обнаружено, что крысы с высокой активностью процессов катаболизма коллагена делают большее число уринаций при тестировании по сравнению с другими животными. В то же время особи с высоким уровнем анаболизма коллагена проявляют в «Открытом поле» повышенную горизонтальную двигательную активность. Учет этих хаpaктеристик поведения и массы тела крыс позволяет предсказывать особенности метаболизма коллагена у животных с точностью до 85%.
...
В работе методом дискриминантного анализа исследована взаимосвязь между уровнем метаболизма коллагена и особенностями поведения крыс в тесте «Открытое поле». Обнаружено, что крысы с высокой активностью процессов катаболизма коллагена делают большее число уринаций при тестировании по сравнению с другими животными. В то же время особи с высоким уровнем анаболизма коллагена проявляют в «Открытом поле» повышенную горизонтальную двигательную активность. Учет этих хаpaктеристик поведения и массы тела крыс позволяет предсказывать особенности метаболизма коллагена у животных с точностью до 85%.
...
17 04 2026 15:20:22
 Статья в формате PDF
100 KB...
Статья в формате PDF
100 KB...
15 04 2026 0:56:25
 Статья в формате PDF
108 KB...
Статья в формате PDF
108 KB...
14 04 2026 23:59:40
Еще:
Поддержать себя -1 :: Поддержать себя -2 :: Поддержать себя -3 :: Поддержать себя -4 :: Поддержать себя -5 :: Поддержать себя -6 :: Поддержать себя -7 :: Поддержать себя -8 :: Поддержать себя -9 :: Поддержать себя -10 :: Поддержать себя -11 :: Поддержать себя -12 :: Поддержать себя -13 :: Поддержать себя -14 :: Поддержать себя -15 :: Поддержать себя -16 :: Поддержать себя -17 :: Поддержать себя -18 :: Поддержать себя -19 :: Поддержать себя -20 :: Поддержать себя -21 :: Поддержать себя -22 :: Поддержать себя -23 :: Поддержать себя -24 :: Поддержать себя -25 :: Поддержать себя -26 :: Поддержать себя -27 :: Поддержать себя -28 :: Поддержать себя -29 :: Поддержать себя -30 :: Поддержать себя -31 :: Поддержать себя -32 :: Поддержать себя -33 :: Поддержать себя -34 :: Поддержать себя -35 :: Поддержать себя -36 :: Поддержать себя -37 :: Поддержать себя -38 ::





